
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
مبادئ وتكنولوجيا طلاء ترسيب البخار الفيزيائي (PVD) (2/2) - VeTek Semiconductor
2024-09-24
طلاء تبخر شعاع الإلكترون
نظرًا لبعض عيوب التسخين بالمقاومة، مثل كثافة الطاقة المنخفضة التي يوفرها مصدر التبخر المقاوم، وبعض تبخر مصدر التبخر نفسه يؤثر على نقاء الغشاء، وما إلى ذلك، يجب تطوير مصادر تبخر جديدة. طلاء التبخر بشعاع الإلكترون عبارة عن تقنية طلاء تضع مادة التبخر في بوتقة مبردة بالماء، وتستخدم شعاع الإلكترون مباشرة لتسخين مادة الفيلم، وتبخير مادة الفيلم وتكثيفها على الركيزة لتشكيل فيلم. يمكن تسخين مصدر تبخر شعاع الإلكترون إلى 6000 درجة مئوية، مما يمكنه إذابة جميع المواد الشائعة تقريبًا، ويمكنه ترسيب أغشية رقيقة على ركائز مثل المعادن والأكاسيد والبلاستيك بسرعة عالية.
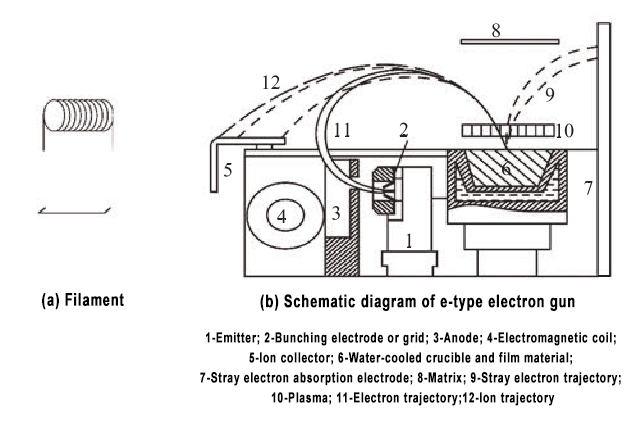
ترسيب نبض الليزر
ترسيب الليزر النبضي (PLD)هي طريقة لصنع الأفلام تستخدم شعاع الليزر النبضي عالي الطاقة لتشعيع المادة المستهدفة (المادة المستهدفة السائبة أو المواد السائبة عالية الكثافة المضغوطة من مادة الفيلم المسحوقة)، بحيث ترتفع المادة المستهدفة المحلية إلى درجة حرارة عالية جدًا في لحظة ويتبخر، ويشكل طبقة رقيقة على الركيزة.
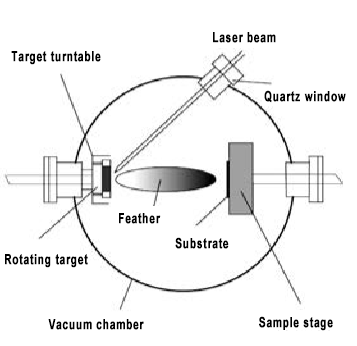
تنضيد الشعاع الجزيئي
تنضيد الشعاع الجزيئي (MBE) عبارة عن تقنية لتحضير الأغشية الرقيقة يمكنها التحكم بدقة في سمك الفيلم الفوقي، وتطعيم الأغشية الرقيقة، وتسطيح الواجهة على المقياس الذري. يتم استخدامه بشكل أساسي لإعداد أغشية رقيقة عالية الدقة لأشباه الموصلات مثل الأغشية الرقيقة جدًا والآبار الكمومية متعددة الطبقات والشبكات الفائقة. إنها إحدى تقنيات الإعداد الرئيسية للجيل الجديد من الأجهزة الإلكترونية والأجهزة الإلكترونية الضوئية.
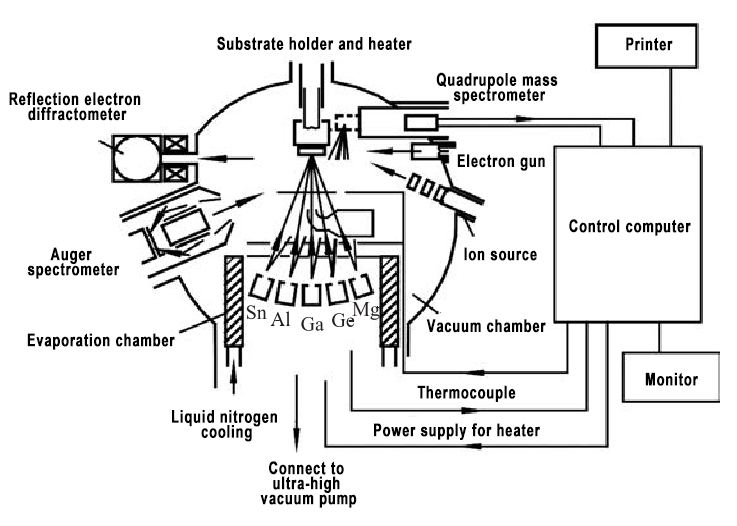
تنضيد الشعاع الجزيئي هو طريقة طلاء تضع مكونات البلورة في مصادر تبخر مختلفة، وتسخن مادة الغشاء ببطء في ظل ظروف فراغ عالية جدًا تبلغ 1e-8Pa، وتشكل تدفق شعاع جزيئي، وترشه على الركيزة عند درجة حرارة معينة. سرعة الحركة الحرارية ونسبة معينة، تنمو أغشية رقيقة فوقية على الركيزة، وتراقب عملية النمو عبر الإنترنت.
في جوهرها، هو عبارة عن طلاء تبخر فراغي، يتضمن ثلاث عمليات: توليد الشعاع الجزيئي، ونقل الشعاع الجزيئي، وترسيب الشعاع الجزيئي. يظهر الرسم التخطيطي لمعدات الشعاع الجزيئي أعلاه. يتم وضع المادة المستهدفة في مصدر التبخر. كل مصدر تبخر لديه يربك. يتم محاذاة مصدر التبخر مع الركيزة. درجة حرارة تسخين الركيزة قابلة للتعديل. بالإضافة إلى ذلك، يوجد جهاز مراقبة لمراقبة البنية البلورية للفيلم الرقيق عبر الإنترنت.
طلاء الاخرق فراغ
عندما يتم قصف السطح الصلب بالجزيئات النشطة، تصطدم الذرات الموجودة على السطح الصلب بالجزيئات النشطة، ومن الممكن الحصول على طاقة وزخم كافيين والهروب من السطح. وتسمى هذه الظاهرة الاخرق. الطلاء المتطاير عبارة عن تقنية طلاء تقصف الأهداف الصلبة بجزيئات نشطة، وترش ذرات الهدف وترسبها على سطح الركيزة لتكوين طبقة رقيقة.
يمكن أن يؤدي إدخال مجال مغناطيسي على السطح المستهدف للكاثود إلى استخدام المجال الكهرومغناطيسي لتقييد الإلكترونات، وتوسيع مسار الإلكترون، وزيادة احتمالية تأين ذرات الأرجون، وتحقيق تفريغ مستقر تحت ضغط منخفض. وتسمى طريقة الطلاء المبنية على هذا المبدأ طلاء الرش المغنطروني.
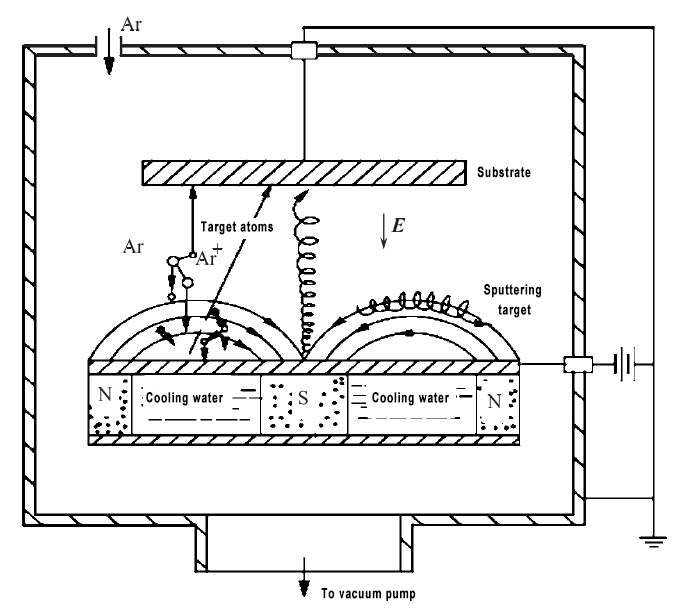
الرسم البياني المبدأيالاخرق المغنطرون العاصمةكما هو مبين أعلاه. المكونات الرئيسية في غرفة الفراغ هي هدف الرش المغنطروني والركيزة. الركيزة والهدف يواجهان بعضهما البعض، الركيزة مؤرضة، والهدف متصل بجهد سلبي، أي أن الركيزة لديها إمكانات إيجابية بالنسبة للهدف، وبالتالي فإن اتجاه المجال الكهربائي يكون من الركيزة إلى الهدف. يتم وضع المغناطيس الدائم المستخدم لتوليد المجال المغناطيسي على الجزء الخلفي من الهدف، وتشير خطوط القوة المغناطيسية من القطب N للمغناطيس الدائم إلى القطب S، وتشكل مساحة مغلقة مع سطح هدف الكاثود.
يتم تبريد الهدف والمغناطيس بواسطة الماء البارد. عندما يتم إخلاء غرفة التفريغ إلى أقل من 1e-3Pa، يتم ملء Ar في غرفة التفريغ إلى 0.1 إلى 1Pa، ثم يتم تطبيق الجهد على القطبين الموجب والسالب لتفريغ توهج الغاز وتكوين البلازما. تتحرك أيونات الأرجون الموجودة في بلازما الأرجون نحو هدف الكاثود تحت تأثير قوة المجال الكهربائي، وتتسارع عند المرور عبر منطقة الكاثود المظلمة، وتقصف الهدف، وتطلق ذرات الهدف والإلكترونات الثانوية.
في عملية الطلاء بالرش بالتيار المستمر، غالبًا ما يتم إدخال بعض الغازات التفاعلية، مثل الأكسجين والنيتروجين والميثان أو كبريتيد الهيدروجين وفلوريد الهيدروجين وما إلى ذلك. وتضاف هذه الغازات التفاعلية إلى بلازما الأرجون ويتم تحفيزها أو تأينها أو تأينها مع Ar الذرات لتكوين مجموعة متنوعة من المجموعات النشطة. تصل هذه المجموعات المنشطة إلى سطح الركيزة مع الذرات المستهدفة، وتخضع لتفاعلات كيميائية، وتشكل أفلامًا مركبة مقابلة، مثل الأكاسيد، والنيتريدات، وما إلى ذلك. وتسمى هذه العملية بالرش المغنطروني التفاعلي DC.
VeTek Semiconductor هي شركة صينية محترفة لتصنيعطلاء كربيد التنتالوم, طلاء كربيد السيليكون, الجرافيت الخاص, سيراميك كربيد السيليكونوسيراميك أشباه الموصلات الأخرى. تلتزم شركة VeTek Semiconductor بتوفير حلول متقدمة لمختلف منتجات الطلاء لصناعة أشباه الموصلات.
إذا كانت لديك أي استفسارات أو كنت بحاجة إلى تفاصيل إضافية، فلا تتردد في الاتصال بنا.
الغوغاء/واتساب: +86-180 6922 0752
البريد الإلكتروني: anny@veteksemi.com



